BGA短路失效分析
- 时间:2020-01-05作者:优尔鸿信检测技术(深圳)有限公司浏览:2386
问题描述
客户描述,其产品回流焊后大量锡球中都存在大气泡(已远远过IPC-A-610E要求的25%),并且存在桥接的现象。(如下图X-Ray 所示)不良发生在上图BGA U1位置,不良率约为1%。PCB表面处理为OSP。客户反映,只有该批次PCB经焊接后出现气泡异常现象。
?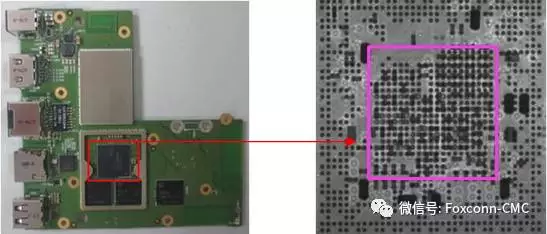
原因分析
PCB:受潮或残留水分,存在盲孔结构,孔壁有裂缝或孔底有尖角,焊盘表面OSP膜异常或存在**污染
BGA: 锡球表面存在裂纹,残留水分, 锡球表面**污染
锡膏: 锡膏吸湿, Flux活性不足或沸点过低
1.强活性的助焊剂使润湿速度加快, 减少助焊剂残渣被焊锡包裹的机会。
2.溶剂过早挥发使得助焊剂残留难以流动,只能在焊锡内部被高温裂解,形成气泡。
Profile:回流参数设置不合理
1.延长预热时间,可利于焊锡内溶剂充分挥发
2.延长TOL,让熔融焊锡内的气体有足够时间逃溢
3.但时间过长的回流会加剧助焊剂裂解
BGA客户无法提供原物料,暂不对其进行分析, 客户反映,锡膏和回流曲线一直未变,而之前并无发现不良,所以暂不考虑这两个因素的影响。客户反映,只有该批次PCB出现不良,初步锁定PCB进行重点分析。
实验验证----NG成品焊点切片分析?
?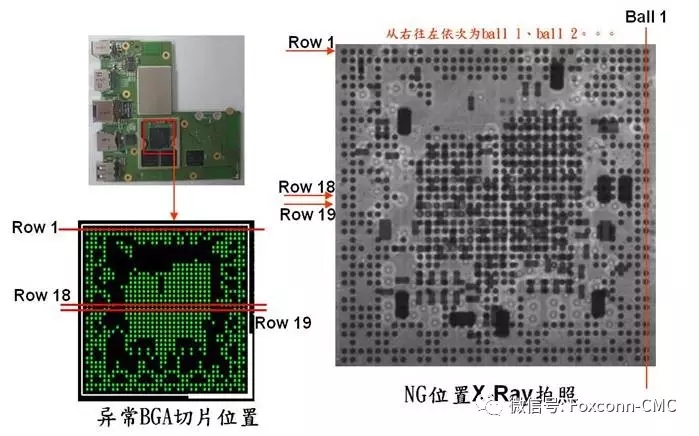
01切片一刀(row 1)
?

?
切片一刀选取NG样品中并无发现大气泡的row 1位置,row 1中ball 11的盲孔位置存在疑似开裂的现象,并且盲孔的疑似开裂位置存在小气泡,该锡球的其他位置并无发现有气泡存在。
02切片二刀(row 18)
?
对Row 18中的30个锡球观察后发现这些锡球可以分为三类:
(1)无盲孔的锡球:该类锡球基本无气泡或有较小的气泡;
(2)盲孔疑似开裂的锡球:大气泡均存在于该类锡球中,并且所有的气泡均在靠近PCB一侧,可以判断大气泡是由PCB这一侧开始产生的;
(3)有盲孔无疑似开裂的锡球:这类锡球基本也无气泡或有较小的气泡。
03切片三刀(row 19)
?
对row 19中的bal 18和ball 19(两个锡球均有大气泡)做SEM+EDS分析:
(1)Ball 18中位置2基本上没有Cu,说明盲孔在该位置的Cu已近缺失,可以判断盲孔在此处确有开裂现象。
(2)Ball 19中的位置2同样存在Cu缺失的现象,同样可以确认盲孔在此处开裂。
??

Row19-ball 18
?

?
Row19-ball 19
结果分析
(1)BGA中主要存在3类锡球,即无盲孔的锡球,有盲孔但盲孔无开裂的锡球和盲孔开裂的锡球,发现大气泡都只存在于盲孔开裂的锡球中,可以判断PCB侧盲孔开裂是大气泡形成的主要原因。
(2)桥接均发生在相邻的两个有大气泡的锡球之间,单个大气泡或没有大气泡的锡球之间并无发现桥接的现象,可以判断桥接主要是由于大气泡的生成,导致焊盘上的锡被挤压到焊盘外而形成的
改善建议?
改善PCB生产的质量监管,要做到PCB上有盲孔的焊盘中盲孔无开裂。
优尔鸿信检测技术(深圳)有限公司专注于成都电子元器件检测,扫描电镜测试,环境可靠性试验,金属检测,三坐标尺寸检测,零件清洁度检测,PCBA板检测等, 欢迎致电 13688306931
词条
词条说明
建筑材料检测的认识(一) 建筑钢筋焊接接头拉伸试验 拉伸试验是力学性能试验中较常见,也是较重要的实验方法之一。通过拉伸试验可以得到材料的弹性模量、屈服强度、规定非比例延伸强度、抗拉强度、断伸长率、断面收缩率、应变硬化指数和苏醒应变比等基本力学性能参数。对于材料的采购和验收、产品的质量控制以及设备的安全和评估都有很重要的参考价值。 拉伸试验规格: 各种钢筋焊接接头的拉伸试验的尺寸按《JGJ/T 27
实验室哪些仪器需要校准,哪些需要检定,很多人都会纠结这个问题,校准是自愿的民事行为,检定是强制的法律行为,可以这样认为:除开强制检定的仪器设备外,其他的都可以适用校准。 那么对于实验室哪些器具需要强制检定,强制检定必须满同时足下列两个条件: 一、器具是于贸易结算、安全防护、医疗卫生、环境监测(未来可能增加:法定评价、公正计量) 二、在下列所列61种的强制检定表的范围内 例如:列表的
硅的测定 一、试剂: 1、稀硝酸(1+4):在80毫升水中加硝酸20毫升,摇匀。 2、高锰酸钾溶液(5%)称5克高锰酸钾溶于水,用水稀至100毫升。 3、碱性钼酸铵溶液:称取5克钼酸铵,加12.5克碳酸钾,溶解后,稀至100毫升。 4、草酸(2.5%)在500毫升水中加草酸12.5克,溶解。 5、硫酸亚铁铵溶液(1%),100毫升水中加1克硫酸亚铁铵,1毫升硫酸。 二、操作步骤: 称取试样30毫克
[摘要] 据**部消息,截至6月30日,全国31个省(区、市)全部制定出台新的**鉴定收费标准,为**诉讼、维护当事人合法权益提供了重要依据。 据**部消息,截至6月30日,全国31个省(区、市)全部制定出台新的**鉴定收费标准,为**诉讼、维护当事人合法权益提供了重要依据。 按照规定,**鉴定机构提供鉴定服务,可以按照标准收取服务费用。但**鉴定服务存在严重的信息不对称性,老百姓缺乏
联系方式 联系我时,请告知来自八方资源网!
公司名: 优尔鸿信检测技术(深圳)有限公司
联系人: 邹先生
电 话: 028-68522005
手 机: 13688306931
微 信: 13688306931
地 址: 四川成都郫都区高新区西部园区合作路888号
邮 编:
相关推荐
相关阅读
1、本信息由八方资源网用户发布,八方资源网不介入任何交易过程,请自行甄别其真实性及合法性;
2、跟进信息之前,请仔细核验对方资质,所有预付定金或付款至个人账户的行为,均存在诈骗风险,请提高警惕!
- 联系方式
- 相关企业
- 武汉多博科技有限公司
- 慧宇昊(北京)检验检测中心有限公司
- 宁波江北澳美检测研究院有限公司
- 湖南竞为联合企业咨询有限公司
- 深圳市新众包科技有限公司
- 苏州知标认证咨询服务有限公司
- 精准通检测认证(广东)有限公司
- 商家产品系列
- 产品推荐
- 资讯推荐



















